芯片,被喻为“现代工业的粮食”。
制造芯片,
就像在微观世界盖一栋房子,
要有好图纸,要打好地基,
随后逐层加盖。
那么,如何让芯片之间的连接
距离最短、间距最小,
实现高精度、低成本?
现代工业发展产生的这一强烈需求,
催生出3D封装技术。
但目前这项技术
在国内发展尚不成熟。
今天,合肥科学岛上传来消息,
中科院合肥研究院智能所
陈池来课题组李山博士等,
发展了一种面向3D先进封装的
玻璃金属穿孔工艺
(Through Glass Via, TGV),
可实现高频芯片、先进MEMS传感器的
低传输损耗、高真空晶圆级封装。
传统的平面化2D封装,已经无法满足高密度、轻量化、小型化的强烈需求。玻璃金属穿孔(TGV)是一种应用于圆片级真空封装领域的新兴纵向互连技术,为实现芯片-芯片之间距离最短、间距最小的互联提供了一种新型技术途径,具有优良的电学、热学、力学性能,在射频芯片、高端MEMS传感器、高密度系统集成等领域具有独特优势,是下一代5G、6G高频芯片3D封装的首选之一。
然而,TGV技术研发存在高均一性玻璃微孔阵列制造、玻璃致密回流、玻璃微孔金属高致密填充等难题。针对此,李山博士等结合中科院合肥研究院和中国科大微纳研究与制造中心的前期研究基础及平台优势,攻克一系列技术难题,提出一种新型TGV晶圆制造方案,开发出高均一性、高致密、高深宽比的TGV晶圆。
“我们开发的TGV晶圆就像摩天大楼中基板及其中的管线,具有支撑和加强各楼层紧密联系的桥梁作用,且具有超低漏率、超低信号损耗的优势。”李山介绍说。经检测,该团队研制出的TGV晶圆各项主要参数均与国际顶级玻璃厂商肖特、康宁和泰库尼思科等相当,部分参数优于国际水平。
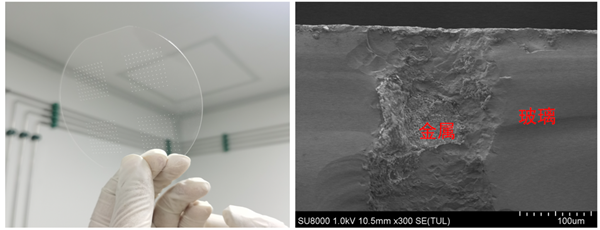
基于导电金属的TGV晶圆(可定制4、6、8英寸)

基于导电硅的TGV晶圆(可定制4、6英寸)
据了解,该项技术具有高度灵活性,可满足诸多定制化需求,经济效益、行业意义重大,在半导体芯片3D先进封装、射频芯片封装、MEMS传感器封装,以及新型MEMS传感器(MEMS质谱、MEMS迁移谱)设计制造、新型玻璃基微流控芯片制作等多个领域具有广阔的应用前景。
相关技术得到了国家自然科学基金、科技部国家重点研发计划、中科院青年创新促进会、中国科大双创基金、华米创新创业基金、中科院合肥物质科学院研究院创新创业基金等支持。
文字 | 全媒体记者 葛清政
编发 | 全媒体编辑 周巧
出品 | “合动力”融媒体工作室
文章链接:https://mp.weixin.qq.com/s/25d76AWQc1l9y49TMoA9aw